本中擬發展目前產業尚無解決方案之五大關鍵瓶頸技術,以協助維持臺灣技術優勢。成果如下:
- 學術表現方面,共發表 SCI 期刊論文 33 篇,屬於 Q1 期刊共 19 篇,其中 Impact Factor > 10 則有 9 篇包括 Advanced Materials, Nature Communications, Nature Electronics, Materials Today Physics 等高影響係數國際頂尖期刊,屬於國際合作成果共 7 篇,屬於 Q1 期刊共 6 篇。另外,於國際研討會發表論文今年共有 42 篇,其中於半導體領域之國際頂尖會議 Symposium on VLSI Technology and Circuits (VLSI) 發表 4篇、International Electron Devices Meeting (IEDM) 共發表 3 篇論文。研發成果豐碩,創新成果受到國際肯定。
- 人才培育方面,共培育碩士生 16 位、博士生 20 位。其中有 1 位取得博士學位、3 位取得碩士學位,分別投入半導體相關產業。國際交換生共 16 位,包含選送表現優秀的 14 名博士生至國際知名研究機構進行學術交流,培養其國際視野與國際合作經驗,對未來厚植台灣之研發實力有莫大助益。
- 在社會貢獻方面,本年度產學合作共 7 案,合計金額共 1,146.6 萬元。合作廠商分別為 Semiconductor Research Corporation、台積電、力積電等科技大廠。顯見研發實力受到產業界肯定。
- 在技術創新方面,開發出多項世界級成果,包含:
1. 以低熱預算液相磊晶技術 (ELLPE) 成功開發晶片級尺寸 (> 3 cm x 3 cm) 單晶矽/鍺薄膜通道層,對高效能積層型三維積體電路晶片之實現有重要突破。
2. 創新發展使用光熱合併的方法成功實現了在超薄氧化銦(In2O3)電晶體大範圍及大面積的 VT 調變展示其應用於低功耗電路設計的潛力。
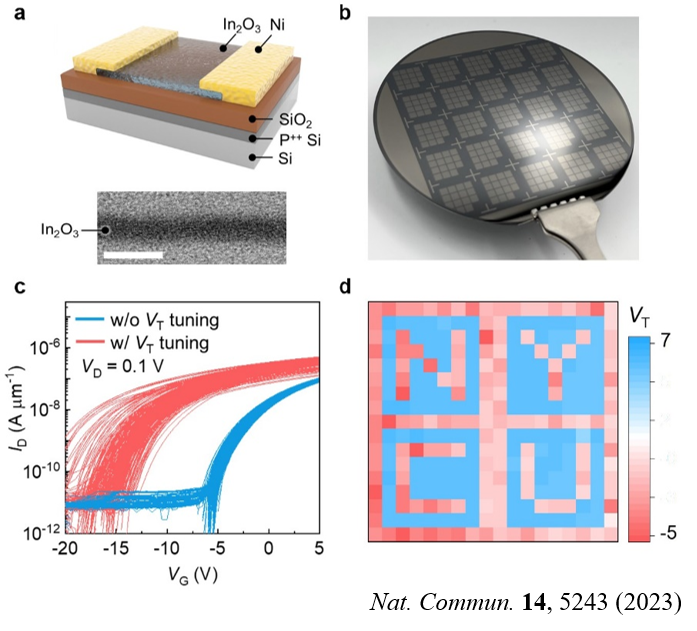
3. 率先以 DFT 計算解析 ALD 初始步驟之反應特性,藉以找出關鍵反應物及適當反應條件,對本實驗團隊開發關鍵之 hAlN 層狀介電層膜製程甚有助益。
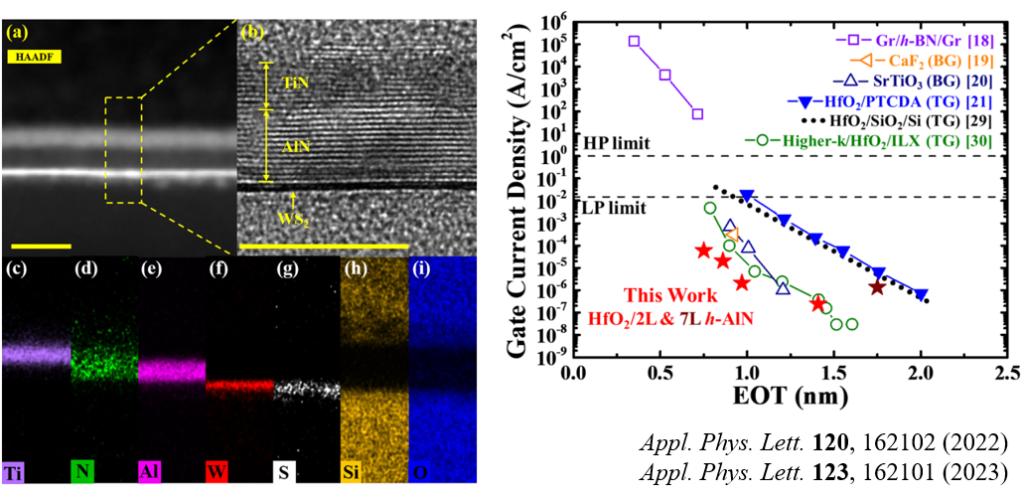
4. 成功開發出以 n+-Si 與 n+-Ge 為基板,接近磊晶方式 PEALD 成長 HZO 薄膜 (~ 8 nm),達到此系統之世界紀錄 2Pr = 84 與 73 μC/cm2 (約 HZO 理論值的 74 % 與 64 %),證實 HZO 薄膜成長推向磊晶方式的可能性。
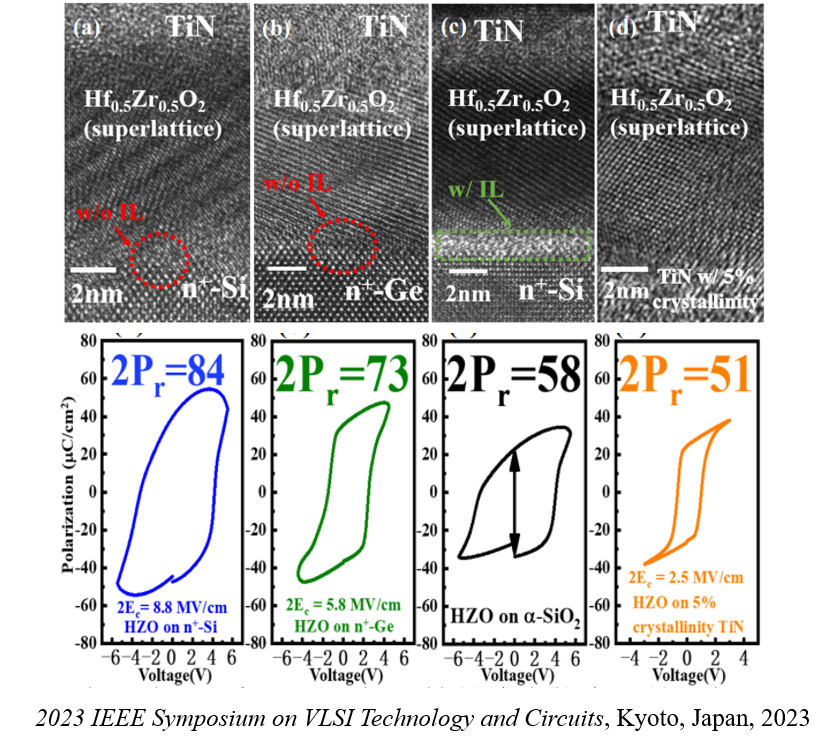
5. 成功開發出低優異電性之 InGaAs FinFET 直流特性與高頻特性皆優良的砷化銦鎵鰭式電晶體,Dit < 1012 eV-1cm-2, ION ~ 900 μA/μm, SS ~ 80 mV/dec, DIBL ~ 100 mV/V, 且 fT = 275 GHz。
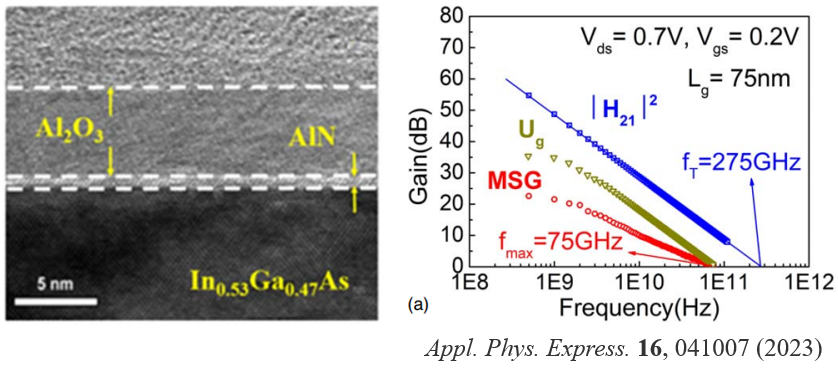
另外,本年度共有 1 件專利獲證,4 件發明專利完成申請程序。這些專利都是獲台積電審查通過,逕行技轉,展現本中心在半導體技術領域之創新研發實力。

